7.30-8.1 全数会2025(第六届)机器人及智能工厂展
火热报名中>>
100nm提升至50nm 中国长城半导体激光隐形晶圆切割获重大突破
9月29日,半导体行业又传来一个好消息,中国长城在晶圆切割技术方面取得重大突破:其旗下郑州轨道交通信息技术研究院联合河南通用智能装备有限公司,仅用了一年时间,便完成了半导体激光隐形晶圆切割设备的技术迭代,分辨率由100nm提升至50nm,达到行业内最高精度,实现了晶圆背切加工的功能。与此同时,持续优化工艺,在原有切割硅材料的技术基础上,实现了加工CIS、RFID、碳化硅、氮化镓等材料的技术突破,对进一步提高我国智能装备制造能力具有里程碑式的意义。

HGL1341晶圆激光隐切设备
半导体产业被称为国家工业的明珠,晶圆切割则是半导体封测工艺中不可或缺的关键工序,是半导体产业的“心脏”。经过“电路制作”后的每一片晶圆上都聚集着数千,数万,甚至十万的"独立功能晶粒”,晶圆分割工艺的好坏直接决定半导体工艺连锁的“生产效率”和”竞争力”的优劣。2020年5月,中国长城旗下郑州轨交院联合河南通用智能装备有限公司,研制出我国首台半导体激光隐形晶圆切割机,填补了国内空白,在半导体激光隐形晶圆切割技术上打破了国外垄断,关键技术性能参数达到了世界领先水平,开启了我国激光晶圆切割行业发展的序幕。
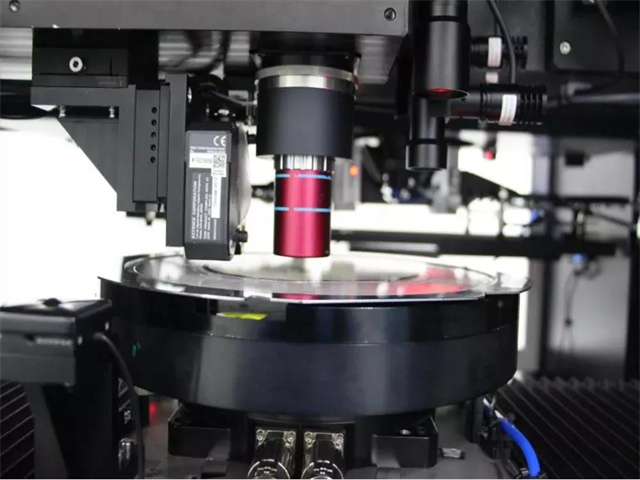
高精度气浮载台
分辨率100nm由提升至50nm,是一次迭代升级。中国长城副总裁、郑州轨交院院长刘振宇介绍到,迭代升级后的激光晶圆隐形切割设备可自由控制激光聚焦点的深度、可自由控制聚焦点的长度、可自由控制两个焦点之间的水平间隔,通过采用特殊材料、特殊结构设计、特殊运动平台,可在500mm/S的高速运动之下,保持高稳定性、高精度切割,激光焦点仅为0.5um,切割痕迹更细腻,可以避免对材料表面造成损伤,大幅提升芯片生产制造的质量、效率、效益。
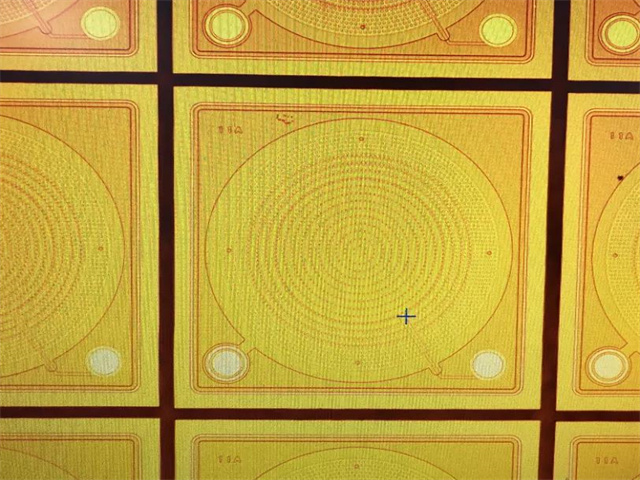
切割无崩边、无碎屑
据介绍,该装备可广泛应用于高能集成电路产品,包括CPU制造、图像处理IC、汽车电子、传感器、新世代内存的制造,对解决我国半导体领域内高端智能装备“卡脖子”问题起到显著作用。

图片新闻
最新活动更多
-
5月22日立即预约>>> 宾采尔激光焊接领域一站式应用方案在线研讨会
-
7.30-8.1火热报名中>> 全数会2025(第六届)机器人及智能工厂展
-
7月30-31日报名参会>>> 全数会2025中国激光产业高质量发展峰会
-
7.30-8.1马上报名>>> 【展会】全数会 2025先进激光及工业光电展
-
免费参会立即报名>> 7月30日- 8月1日 2025全数会工业芯片与传感仪表展
-
精彩回顾立即查看>> 锐科激光《锐见·前沿》系列前沿激光应用工艺分享
推荐专题







 分享
分享




























发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论