7.30-8.1 全数会2025(第六届)机器人及智能工厂展
火热报名中>>
航天三江激光院激光隐切产品中标千万大单
8月16日,航天三江激光院宣布激光隐切产品首开千万大单。公司激光隐形切割晶圆项目组从华东地区传来好消息,中标行业龙头客户项目,订单金额超千万。
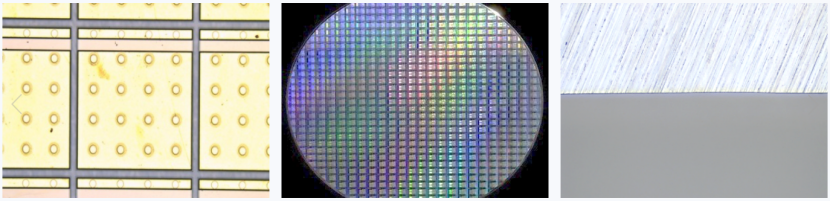
激光隐形切割样品展示 图片来源:航天三江激光产业技术研究院
此次中标,对研究院的激光隐形切割团队具有重要意义。这既是团队落实“保竞标获胜、提精神状态”的一记强音,也是激光院民用激光领域拓展产品市场、扩大客户群体的坚实一步,实现了横向市场竞争项目从零到一的突破。中标千万项目的同时,团队抓紧市场拓展不放松,接续获得半导体激光器芯片行业客户目标订单600万。
传统刀片切割与激光隐形切割
晶圆划片是芯片制造工艺流程中一道不可或缺的工序,在晶圆制造中属于后道工序。晶圆划片就是将做好芯片的整片晶圆按芯片大小分割成单一的芯片(晶粒)。它是采用机械旋转刀片或激光,沿集成电路设计时预留的切割道运动,将晶圆分离成一个个具有独立电气性能的芯片的过程。传统划片工艺多采用机械式旋转刀片切割方式,电路集成密度高的晶圆、高速低功耗芯片晶圆、有特殊结构芯片的晶圆多采用激光划片。
MEMS(Micro-Electro-Mechanical System)即微电子机械系统,一般由微机械结构、微传感器、微执行器和控制电路组成,MEMS是通过半导体工艺实现不同能量形式之间的转换的一种芯片。MEMS的制造主要采用Si材料,与IC(Integrated Circuit Chip)相比,IC是电信号的传输、转换及处理,而MEMS是电信号和其他形式能量间的转换(以机械能为典型),因此在MEMS制造中往往需要利用半导体工艺在Si上制作悬梁、薄膜、空腔、密封洞、针尖、微弹簧等复杂的机械结构,这些微机械结构容易因机械接触而损坏、因暴露而受污染,能承受的机械强度远远小于IC芯片。
传统的晶圆划片采用旋转刀片机械切割方式,通过高速旋转的金刚石刀片划切晶圆完成材料的去除,实现由晶圆到芯片的分割。硅基MEMS晶片的主材料是单晶硅,而硅材料脆性较强,刀片切割方式会带来更突出的崩角、分层和剥离等缺陷。同时,接触式操作也会存在一些弊端。刀具划切在晶体内部产生应力损伤;刀片高速旋转产生的压力、扭力以及振动,会对MEMS芯片中机械微结构造成不可逆的破坏;运行过程中需要使用纯水进行冷却和冲洗,从而产生冲击力;切割的碎屑会造成的晶片污染等。这些弊端会影响芯片内结构的稳定性和可靠性。
激光隐形切割是指将特定波长的激光通过光学系统聚焦在材料内部,该光学系统具有极好的聚焦性能,能够把光压缩到衍射极限,具有较高的峰值功率密度,在材料中间形成改质层(SD层),通过扩展胶膜等方法将工件分割,而不会破坏工件表面和边缘。
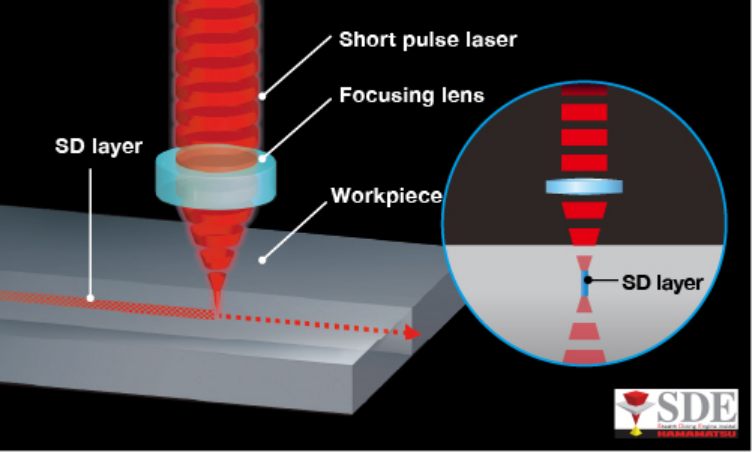
激光隐形切割 图片来源:disco
与刀片切割方式相比,激光隐形切割以其非接触、干式方式,能够解决刀片切割产生的问题。例如,由于工件内部改质,可以抑制加工碎屑的产生,减少工件污染;避免直接接触及纯水冲洗,适用于抗负荷能力差的工件(MEMS等);可以减小切割道宽度,减小芯片间隔。基于其加工优势,激光隐形切割技术被广泛应用于MEMS晶圆、RFID晶圆和Memory晶圆等领域。

隐形切割工艺适用材料 图片来源:滨松

图片新闻
最新活动更多
-
5月22日立即预约>>> 宾采尔激光焊接领域一站式应用方案在线研讨会
-
7.30-8.1火热报名中>> 全数会2025(第六届)机器人及智能工厂展
-
7月30-31日报名参会>>> 全数会2025中国激光产业高质量发展峰会
-
7.30-8.1马上报名>>> 【展会】全数会 2025先进激光及工业光电展
-
免费参会立即报名>> 7月30日- 8月1日 2025全数会工业芯片与传感仪表展
-
精彩回顾立即查看>> 锐科激光《锐见·前沿》系列前沿激光应用工艺分享
推荐专题







 分享
分享




























发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论